[대덕전자]
1. 주가 흐름
2. 기업 개요
[주요 사업]
▶ 반도체 패키지 기판(PKG) : 메모리(DRAM, NAND) 및 비메모리(FC-BGA) 반도체 칩을 메인보드에 연결하는 핵심 PCB 기판을 제조하며, 전체 매출의 약 80%를 차지하는 주력 사업입니다.
▶ 다층회로기판(MLB) : AI 가속기, 서버, 네트워크 장비, 방산 등에 사용되는 20층 이상의 고다층 PCB를 생산하며, AI 데이터센터 확산에 따라 빠르게 성장 중인 사업 부문입니다.
▶ FC-BGA(비메모리 패키지 기판) : 서버·데이터센터·자율주행 등 고성능 시스템 반도체에 적용되는 플립칩 볼그리드어레이 기판으로, 대면적·고다층 제품 개발을 통해 AI 반도체 시장을 공략하고 있습니다.
[기업 기본 정보]
▶ 기업명 : 대덕전자주식회사 (DAEDUCK ELECTRONICS CO.,LTD)
▶ 상장 구분 : 코스피 (KOSPI, 종목코드 353200)
▶ 설립일 : 2020년 05월 01일 (인적분할 신설, 원(原) 대덕전자 1972년 설립)
▶ 회사 소재지 : 경기도 안산시 단원구 강촌로 230
▶ 직원수 : 약 2,500명 (2024년 12월 기준)
▶ 대표자 : 신영환
[최근 시장 관심 이유]
▶ AI 가속기용 MLB 신규 공급 : AMD AI 가속기(MI325X)에 탑재되는 고다층 MLB 양산을 완료하고 2025년 2분기부터 본격 수주가 기대됩니다. 30층 이상 고적층의 고부가 제품으로 기존 대비 데이터 효율이 2배 이상 개선되어 MLB 매출이 급성장할 전망입니다.
▶ 자율주행향 FC-BGA 매출 확대 : 2025년 4분기부터 북미 전기차 업체의 자율주행 반도체향 FC-BGA 공급이 시작되며, 기존 인포테인먼트 중심에서 ADAS·자율주행 플랫폼으로 응용처가 확대되고 있습니다. 자율주행 레벨 3 도입 시 차량 1대당 FC-BGA 탑재량이 2~3개에서 10개로 대폭 증가할 전망입니다.
▶ 실적 턴어라운드 본격화 : 2025년 3분기 영업이익 244억원(전년 대비 +165%)으로 어닝서프라이즈를 기록했으며, 2025년 연간 영업이익은 491억원(전년 대비 +336%)으로 본격적인 턴어라운드 국면에 진입했습니다. 메모리·비메모리·MLB 전 부문에서 수요가 회복되고 있습니다.
3. 주요 연혁
| 일 자 | 내 용 |
| 1972.08 | 한국우라하마전자공업 설립 (고(故) 김정식 회장) |
| 1975.12 | 양면 인쇄회로기판 개발, 상공부 기술개발 공로상 수상 |
| 1977.06 | 대덕전자주식회사로 사명 변경 |
| 1980.04 | 반월공업단지(현 안산)로 본사 이전 |
| 1987.03 | 대덕전자 부설 기술연구소 설립 |
| 1989.10 | 한국증권거래소(현 한국거래소) 유가증권시장 상장 |
| 1996.11 | 필리핀 합작공장(DDPI) 설립 |
| 1997.06 | 시화공장 증설 및 가동 개시 |
| 2014.04 | 아페리오(주) 흡수합병 |
| 2015.03 | 본사 경기도 시흥시로 이전 |
| 2018.12 | 대덕GDS(주) 흡수합병, 연매출 1조원대 PCB 기업 탄생 |
| 2020.04 | HDI(스마트폰 주기판) 생산 종료, 반도체 기판 전문 기업으로 전환 |
| 2020.05 | 인적분할: 지주회사 (주)대덕 / 사업회사 대덕전자(주) 분리 신설 |
| 2020.07 | FC-BGA 신공장 투자 개시 (1차 900억원) |
| 2021.03 | FC-BGA 증설 투자 (2차 700억원 추가 투입) |
| 2021.08 | FC-BGA 신공장 첫 제품 출하 개시 |
| 2022.12 | FC-BGA 생산능력 확대 투자 완료 (총 2,700억원 투입) |
| 2024.03 | 100×100mm 대면적 FC-BGA 개발 성공 (AI 반도체 시장 공략) |
| 2025.03 | AMD AI 가속기(MI325X)향 고다층 MLB 소량 출하 개시 |
4.사업개요
[핵심 사업]
▶ 반도체 패키지 기판(PKG) : 메모리(DRAM, NAND Flash)와 비메모리(AP, CPU 등) 반도체 칩을 메인보드와 전기적으로 연결하는 핵심 PCB 기판입니다. 삼성전자, SK하이닉스, 앰코테크놀로지 등 글로벌 반도체 기업에 납품하며, 스마트폰, PC, 서버, 데이터센터 등 거의 모든 전자기기에 탑재됩니다. 전체 매출의 약 80%를 차지하는 최대 매출원입니다.
▶ 다층회로기판(MLB) : 20층 이상의 고다층 구조를 갖춘 대형 PCB로, AI 가속기(GPU/TPU), 서버, 네트워크 스위치, 방산 장비 등 고성능 시스템에 사용됩니다. 특히 AMD MI325X AI 가속기용 OAM(Open Accelerator Module) 보드를 공급하며, 800G 스위치향 공급도 개시됩니다. 2025년 매출 비중 약 21%, 2026년 약 35%까지 확대 전망입니다.
▶ FC-BGA(비메모리 패키지 기판) : 고성능 CPU, GPU 등 시스템 반도체를 패키징하는 플립칩 볼그리드어레이 기판입니다. 서버·데이터센터, 전기차 인포테인먼트, 자율주행(ADAS) 반도체에 적용되며, 100×100mm 대면적 제품 개발에 성공하여 AI 반도체 패키징 시장을 공략하고 있습니다.
[핵심 기술력 및 기술 난도]
▶ 대면적 FC-BGA 제조 기술 : 가로·세로 각 100mm, 20층 이상의 대면적 고다층 FC-BGA를 양산할 수 있는 기술입니다. 면적이 넓을수록 더 많은 반도체 칩을 패키징할 수 있어 AI 서버용 CPU·GPU 및 2.5D 패키징에 적합합니다. 기존 상용화 제품이 50~90mm 수준이었던 것을 100mm급으로 확대한 것이 핵심 성과입니다.
▶ 타사 대비 차별점 : 국내에서 100mm급 대면적 FC-BGA를 양산 가능한 업체는 삼성전기와 대덕전자 등 극소수이며, 50년 이상의 PCB 제조 노하우를 바탕으로 미세회로 구현과 대면적 기판의 휨(warpage) 제어 기술에서 차별화된 경쟁력을 보유하고 있습니다.
▶ 기술 난도 : FC-BGA는 층수 증가에 따른 정밀 적층 정렬, 대면적에서의 균일한 도금·에칭 제어, 초미세 회로(L/S 10μm 이하) 패터닝 등 극한의 공정 기술이 필요합니다. 전 세계적으로 이비덴, 신코덴키, 삼성전기 등 10여 개 업체만 양산이 가능한 초고진입장벽 분야입니다.
▶ AI 가속기용 고다층 MLB 제조 기술 : 30층 이상의 초고적층 MLB를 제조하는 기술로, AI 가속기의 대용량 데이터 전송과 고속 신호 전달을 지원합니다. HDI(고밀도 인터커넥트) 기술력을 MLB에 접목하여 빌드업 공정이 필요한 OAM 보드까지 제작이 가능합니다.
▶ 타사 대비 차별점 : 과거 HDI 사업에서 축적한 고밀도 PCB 레퍼런스를 다수 보유하고 있어, 단순 MLB를 넘어 빌드업 공정이 요구되는 OAM 보드를 제작할 수 있는 국내 몇 안 되는 업체입니다. 이수페타시스와 함께 국내 AI 가속기용 MLB 양대 공급업체로 자리매김하고 있습니다.
▶ 기술 난도 : 30층 이상 적층 시 각 층간 정밀 정렬(registration), 고주파 신호 손실 최소화를 위한 특수 저유전율 소재 적용, 고밀도 비아(via) 가공 등이 필요합니다. 층수가 늘어날수록 수율이 기하급수적으로 하락하여 양산 안정화에 수년이 소요됩니다.
▶ 고속·고주파 대응 기판 설계 기술 : 5G 통신, 800G 네트워크 스위치 등에 대응하는 High Speed/High Frequency 특수 소재 적용 기판 설계 기술입니다. 신호 무결성(Signal Integrity)과 전력 무결성(Power Integrity)을 동시에 확보하여 초고속 데이터 전송 환경에서도 안정적인 성능을 제공합니다.
▶ 타사 대비 차별점 : 삼성전자, SK하이닉스 등 국내 최대 반도체 기업과의 오랜 협력을 통해 메모리·비메모리·네트워크 전 분야에 걸친 다양한 제품 포트폴리오를 보유하고 있으며, 고객사 맞춤형 설계 역량에서 차별화됩니다.
▶ 기술 난도 : 고주파 환경에서의 전송 손실(insertion loss) 최소화, 임피던스 정밀 제어, 특수 저손실 소재(Low Dk/Df)의 가공성 확보 등 고도의 소재·설계·공정 통합 기술이 필요합니다. 주파수가 높아질수록 기판 내 미세한 결함이 신호 품질에 치명적 영향을 미쳐 극한의 품질 관리가 요구됩니다.
[신규 사업]
▶ 자율주행 반도체용 FC-BGA : 2025년 4분기부터 북미 전기차 업체의 자율주행 칩용 FC-BGA 공급을 개시하며, 기존 인포테인먼트 중심에서 ADAS·자율주행 플랫폼으로 사업 영역을 확장하고 있습니다. 자율주행 레벨 3 도입 시 차량당 FC-BGA 탑재량이 2~3개에서 10개로 대폭 증가할 전망입니다.
▶ Physical AI 메인칩용 FC-BGA : 2026년부터 Physical AI(로봇, 자율주행 등 물리적 환경에서 동작하는 AI) 메인칩용 FC-BGA 기판 개발에 착수할 예정이며, 서버급 대면적 FC-BGA의 생산 개시도 2026년 하반기에 예정되어 있습니다.
▶ AI 가속기용 OAM 보드 : AMD MI325X 등 차세대 AI 가속기에 탑재되는 OAM(Open Accelerator Module) 보드를 개발·양산하며, 기존 UBB(Unit Base Board)를 넘어 빌드업 공정이 요구되는 고부가 MLB 영역으로 사업을 확대하고 있습니다.
5. 주요 제품 매출 구성
| 사업부문 | 주요 제품 | 2022년 | 2023년 | 2024년 | |
| 반도체 PKG | 메모리 기판 | DRAM, NAND, FC-BGA 등 | 11,287억원 | 7,967억원 | 7,696억원 |
| 비메모리 기판 | |||||
| MLB | 다층회로기판 | 서버, 네트워크, 방산, AI 가속기 | 1,390억원 | 1,100억원 | 1,225억원 |
| 합 계 | - | 13,162억원 | 9,097억원 | 8,921억원 | |
6-1 연간 재무
6-2 분기 재무
7. 주주 정보
| 성 명 | 관 계 | 주식의 종류 | 소유주식수 및 지분율 | 비 고 | |||
| 기 초 | 기 말 | ||||||
| 주식수 | 지분율 | 주식수 | 지분율 | ||||
| (주)대덕 | 계열회사 | 보통주 | 15,546,152 | 31.46% | 15,546,152 | 31.46% | - |
| 사회복지법인대덕복지재단 | 기타 | 보통주 | 526,622 | 1.07% | 526,622 | 1.07% | - |
| (재)해동과학문화재단 | 기타 | 보통주 | 89,000 | 0.18% | 89,000 | 0.18% | - |
| 신영환 | 대덕전자(주) 등기임원 | 보통주 | 18,192 | 0.04% | 18,192 | 0.04% | - |
| 배영근 | 대덕전자(주) 등기임원 | 보통주 | 5,082 | 0.01% | 5,082 | 0.01% | - |
| 김지호 | 계열회사 임원 | 보통주 | 4,738 | 0.00% | 4,738 | 0.00% | - |
| 계 | 보통주 | 16,219,169 | 32.82% | 16,189,786 | 32.76% | - | |
| 성명 | 생년월일 | 직위 | 담당업무 | 주요경력 | 소유주식수 | 재직기간 | 임기만료일 |
| 신영환 | 1960.11 | 대표이사 (사내이사) |
경영총괄 | 성균관대학교 경영대학원 경영학 석사 현재 대덕전자(주) 사장 |
18,192 | 2015.03~ | 2026.03.21 |
| 김영재 | 1959.01 | 사장 (사내이사) |
경영총괄 | 한국과학기술원 화학과 현재 (주)대덕 사장 |
- | 2022.07~ | 2027.03.27 |
| 배영근 | 1968.10 | 실장 (사내이사) |
경영기획 | 한양대 산업경영대학원 경영학과 현재 대덕전자(주) 실장 |
5,082 | 1993.02~ | 2025.03.23 |
| 조순진 | 1967.10 | 본부장 (미등기) |
기술총괄 | 한국과학기술원 대학원 신소재공학 박사 현재 대덕전자(주) 본부장 |
- | 2022.01~ | - |
| 고영주 | 1966.12 | 본부장 (미등기) |
연구개발 | 한양대학교 대학원 금속공학과 현재 대덕전자(주) 본부장 |
- | 2021.04~ | - |
8. 관련 정보

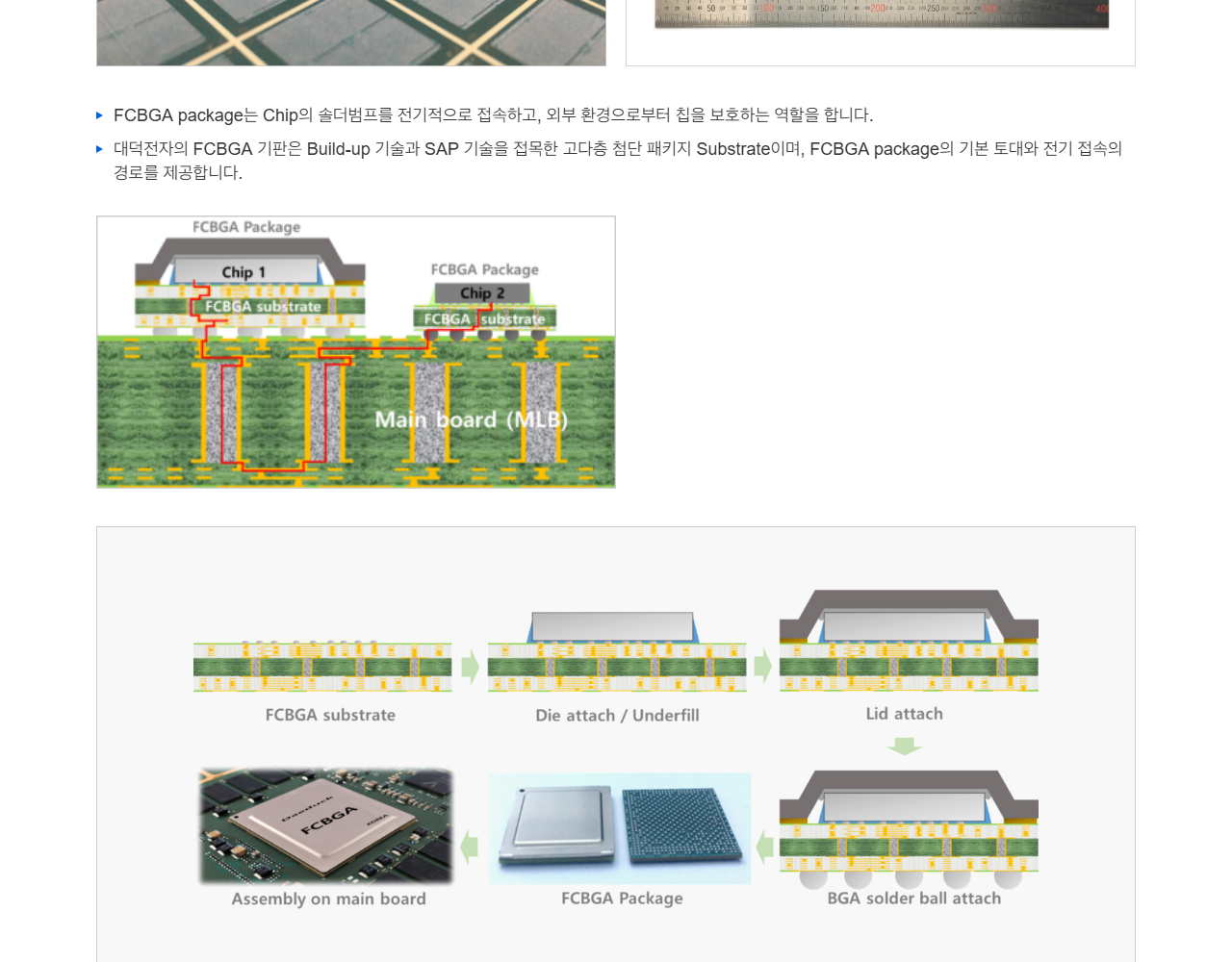



9-1 관련 기사
-제목 : 대덕전자, 대면적 FC-BGA 개발..."AI 반도체 시장 공략"
-날짜 : 2024년 03월 31일
-내용 : 대덕전자가 가로·세로 각 100mm, 20층 이상의 대면적 FC-BGA 개발에 성공했다. 기존 상용화 제품(50~90mm)보다 2배 큰 규모로, AI 서버용 고성능 CPU·GPU 패키징과 2.5D 패키징에 적용 가능하다. 신영환 대표는 글로벌 주요업체와 협업을 통해 AI 및 자율주행 분야 시장 점유율 확대에 주력하겠다고 밝혔다.
-링크 : https://www.etnews.com/20240329000014
9-2 관련 기사
-제목 : 대덕전자, AMD향 'AI 가속기' MLB 공급 최종승인 앞둬
-날짜 : 2024년 11월 05일
-내용 : 대덕전자가 미국 AMD의 AI 가속기에 탑재되는 고다층 MLB(다층회로기판) 공급을 위한 최종 승인 절차를 진행 중이다. UBB뿐만 아니라 빌드업 공정이 필요한 고난이도 OAM 보드도 함께 공급할 것으로 전망된다. 대덕전자는 과거 HDI 사업에서 축적한 고밀도 PCB 제조 역량을 AI 가속기 MLB에 접목하고 있다.
-링크 : https://www.newsis.com/view/NISX20241105_0002946846
9-3 관련 기사
-제목 : 대덕전자, 3분기 어닝 서프라이즈..."FC-BGA 응용처 확대"
-날짜 : 2025년 10월 30일
-내용 : 대덕전자가 2025년 3분기 매출 2,862억원, 영업이익 244억원을 기록하며 전년 대비 영업이익이 165% 급증했다. FC-BGA 응용처가 전기차에서 내연기관 차량까지 확대되었고, 인포테인먼트에서 자율주행·ADAS로 수요가 확장되면서 라인 가동률이 크게 개선되었다. FC-BGA 매출 비중은 3분기 17%까지 상승했다.
-링크 : https://www.thelec.kr/news/articleView.html?idxno=43454
9-4 관련 기사
-제목 : 대덕전자, 美 반도체 AMD향 AI MLB 양산...수주 초읽기
-날짜 : 2025년 04월 10일
-내용 : 대덕전자가 AMD AI 가속기(MI325X)에 탑재되는 고다층 MLB를 2025년 3월부터 소량 출하를 시작했으며, 2분기부터 본격 공급을 위해 발주서를 기다리고 있다. 해당 MLB는 30층 이상 고적층의 고부가 제품으로, 기존 대비 데이터 효율이 2배 이상 개선되었다. MLB 매출은 올해 1,900억원에서 내년 3,100억원으로 63% 성장할 전망이다.
-링크 : https://www.newsis.com/view/NISX20250410_0003134420
9-5 관련 기사
-제목 : 대덕전자, 북미 전기차 업체향 '자율주행 핵심' FC-BGA 본격 공급..."밸류 재평가에 주가 상승"
-날짜 : 2025년 11월 05일
-내용 : 대덕전자가 북미 전기차 업체의 자율주행 반도체향 FC-BGA를 2025년 4분기부터 본격 공급을 개시한다. 기존 인포테인먼트·디지털클러스터 중심이던 FC-BGA 수요가 자율주행·ADAS로 확대되며 단가 상승도 기대된다. 향후 자율주행 레벨 3 도입 시 차량당 FC-BGA 탑재량이 현재 2~3개에서 10개로 대폭 증가할 전망이다.
-링크 : https://m.newsprime.co.kr/section_view.html?no=716942&menu=1
10. 사업 검토
| 구분 | 대덕전자 (Target) | 이수페타시스 (경쟁사 1) | 심텍 (경쟁사 2) |
| 회사명 | 대덕전자(주) | 이수페타시스(주) | 심텍(주) |
| 기업 성격 | 반도체 패키지 기판(PKG) + MLB 전문 PCB 기업 | 초고다층 MLB(서버·네트워크·AI 가속기용) 전문 PCB 기업 | 반도체 패키지 기판(FC-CSP, SiP, 모듈PCB) 전문 기업 |
| 시가 총액 | 약 3.1조원 | 약 8.1조원 | 약 7,000억원 |
| 2024년 매출 | 약 8,921억원 | 약 8,369억원 | 약 1조 2,060억원 |
| 2024년 순이익 | 약 228억원 | 약 700억원 | 영업손실 약 498억원 |
| 주력 제품 | 메모리·비메모리 PKG 기판, FC-BGA, MLB | 초고다층 MLB (AI 가속기, 서버, 네트워크용) | 메모리 모듈 PCB, FC-CSP, SiP 모듈 기판 |
| 핵심 보유 기술 | 대면적 FC-BGA, 고다층 MLB, 고속·고주파 기판 설계 | 50층+ 초고다층 MLB, 고속신호 전송, HDI 복합 기술 | FC-CSP 미세회로, 슬림 FC-BGA, SiP 모듈 기판 |
| 차별화 강점 | PKG+MLB+FC-BGA 풀라인업 보유, 삼성전자·SK하이닉스 등 국내 주요 반도체 기업 직접 납품 | 엔비디아·구글·MS 등 글로벌 빅테크 직납, AI 가속기 MLB 분야 글로벌 톱티어 | 글로벌 Big5 메모리칩메이커 전량 거래, HBM·DDR5 전환 수혜 |
| 비고 | 대상 기업 | AI 가속기용 MLB 직접 경쟁, 엔비디아·구글 공급으로 시장 선점 | 메모리 기판 분야 경쟁, FC-CSP·SiP 영역에서 기술 차별화 |
[핵심 분야별 상세 성장성 분석]
► AI 가속기용 MLB : 데이터센터 투자 확대로 급성장하는 고부가 기판 시장
글로벌 AI 가속기 시장은 2024년 약 450억 달러에서 2030년 약 2,100억 달러로 CAGR 약 29% 성장이 전망됩니다. AI 가속기에 탑재되는 고다층 MLB는 30층 이상의 초고적층 구조가 요구되며, 대덕전자는 AMD MI325X용 OAM 보드 양산을 시작으로 이 시장에 본격 진입했습니다. MLB 매출은 2024년 1,225억원에서 2025년 약 1,900억원, 2026년 약 3,100억원으로 급성장이 예상되며, 전체 매출에서 MLB 비중이 2024년 14%에서 2026년 35%까지 확대될 전망입니다. 다만 이수페타시스가 엔비디아·구글에 이미 대량 납품 중이어서 고객 다변화와 기술 차별화가 중요한 과제입니다.
► 자율주행·전장용 FC-BGA : 자동차 반도체 고도화에 따른 구조적 수요 증가
글로벌 FC-BGA 시장은 2025년 약 113억 달러에서 2030년 약 204억 달러로 CAGR 약 10.3% 성장이 전망됩니다. 특히 자율주행 레벨 3 도입 시 차량 1대당 FC-BGA 탑재량이 현재 2~3개에서 10개로 대폭 증가하여 FC-BGA 수요가 폭발적으로 늘어날 전망입니다. 대덕전자는 2025년 4분기부터 북미 전기차 업체의 자율주행 반도체향 FC-BGA 공급을 개시하며, FC-BGA 매출이 2024년 약 1,782억원에서 2026년 약 3,163억원으로 78% 성장할 것으로 예상됩니다. FC-BGA 사업은 약 5,400억원의 대규모 투자 이후 가동률 회복 국면에 진입했으며, 2026년 1분기 손익분기점(BEP) 도달이 기대됩니다.
► 반도체 패키지 기판(PKG) : AI·HBM 수요 확대로 메모리 기판 사이클 재개
글로벌 반도체 패키징 시장은 2025년 약 499억 달러에서 2030년 약 812억 달러로 CAGR 약 10.2% 성장이 전망됩니다. DDR4에서 DDR5로의 전환, HBM(고대역폭 메모리) 수요 급증이 메모리 패키지 기판 수요를 견인하고 있으며, 대덕전자는 삼성전자·SK하이닉스에 메모리 기판을 직접 납품하는 핵심 공급업체입니다. 2024년 반도체 업황 부진으로 가동률이 하락했으나, 2025년부터 메모리 업황 회복과 함께 PKG 매출이 반등하고 있으며, 전체 매출의 약 50~60%를 차지하는 캐시카우 역할을 지속할 전망입니다.
[향후 극복 필요한 기술장벽]
► 서버급 대면적 FC-BGA 양산 수율 확보 : 100mm급 이상 초대면적 기판의 안정적 양산이 관건
현재 대덕전자는 100×100mm급 대면적 FC-BGA 개발에 성공했으나, AI 서버용 고성능 CPU·GPU에 적용되는 초대면적 기판의 양산 수율은 아직 개선이 필요한 상황입니다. 기판 면적이 커질수록 층간 정렬 오차, 휨(warpage) 현상, 도금·에칭 균일도 확보가 기하급수적으로 어려워집니다. 이비덴·신코덴키 등 일본 선도업체는 이미 대면적 FC-BGA의 양산 수율을 안정화한 반면, 대덕전자는 아직 가동률이 55~65% 수준에 머물러 있습니다. 수율 확보에 실패할 경우 약 5,400억원의 투자비 회수가 지연되어 수익성에 큰 부담이 될 수 있습니다.
► 초미세 회로 패터닝 기술(L/S 8μm 이하) : 차세대 반도체 패키징을 위한 미세화 한계 극복
AI 반도체의 고집적화에 따라 FC-BGA의 회로 선폭/선간(L/S)이 현재 10~12μm에서 8μm 이하로 미세화되어야 합니다. 그러나 유기기판 위에서의 초미세 패터닝은 구리 도금의 불균일, 에칭 언더컷, 소재 열팽창 등 물리적 한계가 존재합니다. 삼성전기는 SAP(Semi-Additive Process) 공정으로 8μm급 양산을 준비 중이며, 장기적으로는 유리기판(Glass Substrate)으로의 전환이 논의되고 있어 기존 유기기판 기반 기술의 패러다임 전환 리스크가 상존합니다. 대덕전자가 미세화 경쟁에서 뒤처질 경우 고부가 FC-BGA 시장에서의 입지가 약화될 수 있습니다.
► 고주파·저손실 소재 기술 내재화 : AI·5G 시대 핵심 소재의 안정적 확보와 가공 기술
800G 이상의 초고속 네트워크 스위치와 AI 가속기에서는 신호 전송 손실을 최소화하기 위해 저유전율(Low Dk)·저손실(Low Df) 특수 소재가 필수적입니다. 현재 이러한 특수 소재는 미국 Rogers, 일본 Panasonic 등 소수 글로벌 업체에 의존도가 높아 공급 리스크가 존재합니다. 또한 저손실 소재는 기존 FR-4 대비 가공성이 크게 떨어져 드릴링, 적층, 도금 등 전 공정에서 새로운 기술 대응이 필요합니다. 소재 확보 실패 시 800G·1.6T급 차세대 네트워크 장비용 MLB 시장에서 경쟁력을 상실할 위험이 있으며, 소재 내재화 또는 대체 소재 개발이 중장기적으로 반드시 해결해야 할 과제입니다.
'종목탐색 > AI, 반도체' 카테고리의 다른 글
| [종목 탐색] 오픈엣지테크놀로지 (0) | 2026.03.13 |
|---|---|
| [종목 탐색] 삼성전기 (0) | 2026.03.13 |
| [종목 탐색] 한글과컴퓨터 (0) | 2026.03.12 |
| [종목 탐색] SKC (0) | 2026.03.11 |
| [종목 탐색] 케이엔솔 (액침냉각) (1) | 2026.03.08 |